안녕하세요 지난 시간 기판에 대해 공부를 시작했습니다. 처음 접근하다 보니 중구난방 그냥 떠오르는 데로 정리를 해봤는데요, 이번시간에는 패키징의 분류에 집중해서 메모리향과 비메모리향에 어떤 종류의 패키징과 기판들이 있는지 살펴보겠습니다.
이번 자료를 보기 전에 지난 시간 자료를 먼저 읽고 오시면 좋을 것 같습니다.
https://totbox89.tistory.com/14
반도체 기판 공부하기 - (1)
안녕하세요 개인적으로 산업공부를 위해 작성된 글입니다. 전문가가 아니기 때문에 약간의 오류가 있을 수 있으며 댓글로 알려주시면 수정하겠습니다 ^^ 이번시간에는 반도체 기판에 대해서 공
totbox89.tistory.com

우리는 반도체를 크게 시스템반도체와 메모리 반도체로 분류할 수 있습니다. 따라서 패키징도 시스템반도체향과 메모리향으로 분류해 알아보도록 하겠습니다. 먼저 시스템반도체향입니다.
시스템반도체 패키징 종류
시스템 반도체 패키징에서 FC-BGA, FC-CSP, SiP, AiP 등을 알아보도록 하겠다.
1)FC-BGA와 FC-CSP
FC-BGA와 FC-CSP는 둘 다 플립칩(FC) 형태로 기판에 실장 된다. 아래의 그림을 통해 플립칩이 무엇인지 간단히 살펴보자.


플립칩 방식은 지난 시간 와이어본딩과 함께 설명하였으므로 생략하도록 하겠다.
FC-BGA와 FC-CSP의 가장 큰 차이점은 기판 사이즈인데, FC-BGA는 칩보다 기판사이즈가 훨씬 큰 반면 FC-CSP는 칩과 기판사이즈가 거의 유사하다.
FC-BGA는 공간의 활용성보다는 기능에 더 충실하여 고사양 기기에 들어간다. 주로 PC, 노트북, 서버용 CPU 및 GPU에 해당함.
FC-CSP는 공간의 활용성이 중요하기 때문에 초소형 기판이 필요한 모바일에 주로 쓰인다. 모바일 AP와 베이스밴드에 가장 많이 쓰이고 PC/서버용 디램, 블루투스, RF 등에도 활용된다.

2) SiP(System in Package)
SiP는 기판 위에 여러 개의 반도체 칩과 수동소자를 실장 한 후 하나의 시스템으로 구성한 모듈형 패키지 기판이다. 칩 간 경로를 최적화하여 우수한 성능과 전기적 특성을 가진다. 또한 와이어본딩 방식과 플립칩 방식을 혼용하여 사용할 수 있어 설계에 자유로움이 있다. 칩의 수직적층 및 수평배열 등 유연하게 경량화 소형화가 가능하다. 기판과 메인 PCB는 솔더블을 이용한 BGA를 활용한다.
이러한 SiP는 주로 스마트폰, 태블릿, 웨어러블 IoT에 들어가는 각종 RF부품에 사용된다.
(RF부품이란? 안테나와 그 안테나로 전파를 쏘고 받기 위한 각종 회로, 구조물, 주변장치 전반을 의미한다.)
3) AiP(Antenna in Package)
AiP는 5G mmWave(28GHz 이상) 송수신을 지원하는 안테나 모듈용 패키지기판이다. 예전에는 밀리미터파 신호는 기술적 문제로 인해 모바일 무선 통신에 사용되지 못했다. 이유는 다수의 안테나가 설치될 공간이 모바일에서는 부족했기 때문이다.
AiP는 5G 안테나, 필터, 전력증폭기, 송수신 칩 등의 부품을 하나로 모듈화해 초소형화를 구현하여 공간활용뿐만 아니라, 전력 효율도 높였다. AiP도 SiP와 동일하게 와이어본딩, 플립칩 두 가지를 혼용할 수 있고 기판과 메인 PCB는 솔더블을 이용한 BGA를 활용한다. 주로 모바일과 태블릿에 이용된다.
메모리반도체 패키징의 종류
메모리반도체 패키징인 BOC와 MCP에 대해 살펴보자.
1) BOC(Board On Chip)
기판과 메모리칩의 본딩면이 부착된 플립칩 형태이지만 범프가 아닌 와이어본딩을 활용. 메모리칩에 가장 널리 사용되는 기판이다. 플립칩 형태로 칩의 실장 밀도가 높아 기판의 두께는 얇지만 칩의 본딩패드와 기판 사이 공간을 활용하여 금속선으로 연결한다.
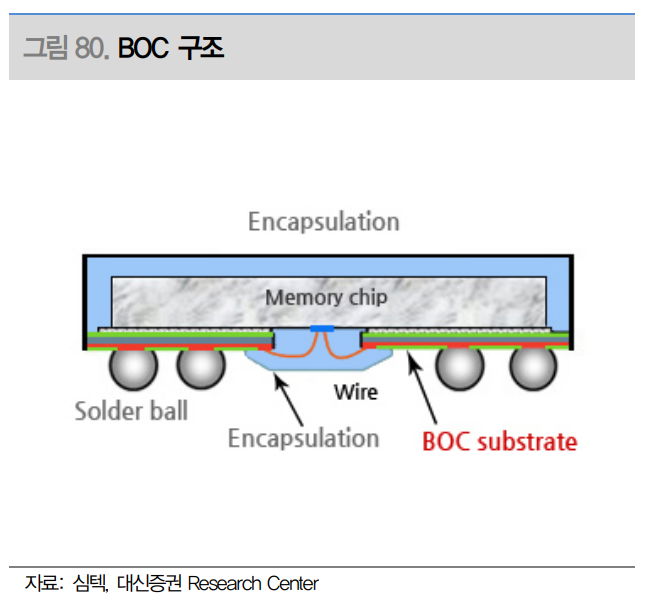
기존 리드프레임을 라미네이트기판으로 대체하여 입출력 핀 수의 다양화와 칩의 수직적층이 가능하여 고속화 및 대용량화에 용이하다. 따라서 메모리칩에 광범위하게 사용되는 패키지 기판이다. 주로 데스크톱, 노트북, 서버, SSD, 그래픽카드용 메모리칩에 적용된다.
2) MCP(Multi Chip Package)
MCP는 여러 개의 칩을 쌓아 올린 후 한 번에 패키지 하는 것을 말한다. 햄버거와 비슷한 구조!
통상 다양한 메모리 칩을 적층 한 후 아래 칩과 위 칩을 금선으로 연결하고 패키지하는 것을 말한다.
여러 개의 칩을 쌓아 올림으로써 공간 효율성을 높이는 것이다. MCP는 공간효율성이 중요한 스마트폰에 주로 사용된다.

오늘은 메모리향과 비메모리향으로 분류한 패키지 기판에 대해 간략히 알아보았습니다.
다음시간에 이어 기판공부를 해보겠습니다.
읽어주셔서 감사합니다.
'재테크' 카테고리의 다른 글
| XR 산업 공부 (VR, AR 등) (0) | 2023.05.07 |
|---|---|
| 반도체 기판 공부하기 - (3) 기판 시장의 흐름 (2) | 2023.05.05 |
| 반도체 기판 공부하기 - (1) (0) | 2023.05.02 |
| 고성능 메모리 DDR5, HBM 공부하기 (2) | 2023.04.22 |
| K 콘텐츠 조정 받고 있나? 아님 나락인가? (0) | 2023.04.13 |



