안녕하세요 지난 시간에 이어 반도체 기판 공부를 이어가겠습니다. 이번 시간에는 기판 시장의 분위기가 어떻게 흘러왔고 앞으로 어떻게 흘러갈 것인지 예측해 보는 시간을 가지려 합니다. 지난 1,2편 글을 보고 오시면 이해하는데 더 도움이 될 수 있을 것 같습니다. 전문가의 글이 아니라 개인 공부 기록용입니다. 증권사 리포트 및 기사를 참고하였습니다.
https://totbox89.tistory.com/14
반도체 기판 공부하기 - (1)
안녕하세요 개인적으로 산업공부를 위해 작성된 글입니다. 전문가가 아니기 때문에 약간의 오류가 있을 수 있으며 댓글로 알려주시면 수정하겠습니다 ^^ 이번시간에는 반도체 기판에 대해서 공
totbox89.tistory.com
https://totbox89.tistory.com/15
반도체 기판 공부하기 - (2) 기판의 분류 상세
안녕하세요 지난 시간 기판에 대해 공부를 시작했습니다. 처음 접근하다 보니 중구난방 그냥 떠오르는 데로 정리를 해봤는데요, 이번시간에는 패키징의 분류에 집중해서 메모리향과 비메모리
totbox89.tistory.com
기판의 전방 수요에 대하여 (패키징 기술의 발전과 FC-BGA의 대면적화)
반도체 기판 수요는 CPU 세대 변화, 데이터 사용량 증가에 따른 서버향 반도체 출하, Ai와 자율주행 등 새로운 산업의 발전, 5G 통신 세대 변화 등 여러 요인의 영향을 받을 것으로 보인다.
여러 기판 중에서도 FC-BGA기판의 경우 CPU/GPU를 비롯한 Ai 칩의 성장과 궤를 함께 할 것이기 때문에 장기적으로 수요는 더 커질 것으로 기대된다.
서버/데이터용 CPU에 채택되는 AMD의 칩렛 구조나 인텔의 EMIB는 패키지기판의 대면적화를 이끈다. 사이즈 제약이 있는 PC/노트북 등의 CPU에는 적층이 고도화된 3D 패키징 기술을 도입하는 이는 패키지 기판의 고다층화를 야기한다. 이로 인해 패기지 기판 CAPA의 공정부하가 증가하게 된다.
21년의 PC용 패키지 기판의 제조부하가 1이라면, 서버용 패키지 기판의 공정 부하는 6.5가 된다. 이로 인해 FC-BGA의 CAPA 증설로 이어지고 있는 상황이다.


결국 고객사의 패키징 기술이 진화할수록 기판 면적 및 층수 부하는 늘어나게 된다.
인텔의 패키징 기술과 FC-BGA


인텔은 서버용에는 면적 제약이 적어 EMIB를 PC용에는 면적제약으로 Foveros를 적용할 계획이다.
인텔의 EMIB 기술은 서버/데이터센터용 CPU인 사파이어 레피즈 시리즈에 적용. Foveros 기술은 PC용 CPU인 Meteor Lake에 적용된다.
EMIB 기술은 2.5D 패키징 기술로 대면적화를, Foveros는 3D 패키징 기술로 적층의 고도화를 통해 고다층화를 이룬다.
AMD의 패키징 기술과 FC-BGA
AMD의 칩렛 방식도 FC-BGA 대면적화의 주요인이 된다.
AMD는 여러 개의 다이를 결합한 디자인인 칩렛 방식의 CPU를 고안했다. 칩렛에 관한 자세한 설명은 이전 글을 참고하길 바란다.
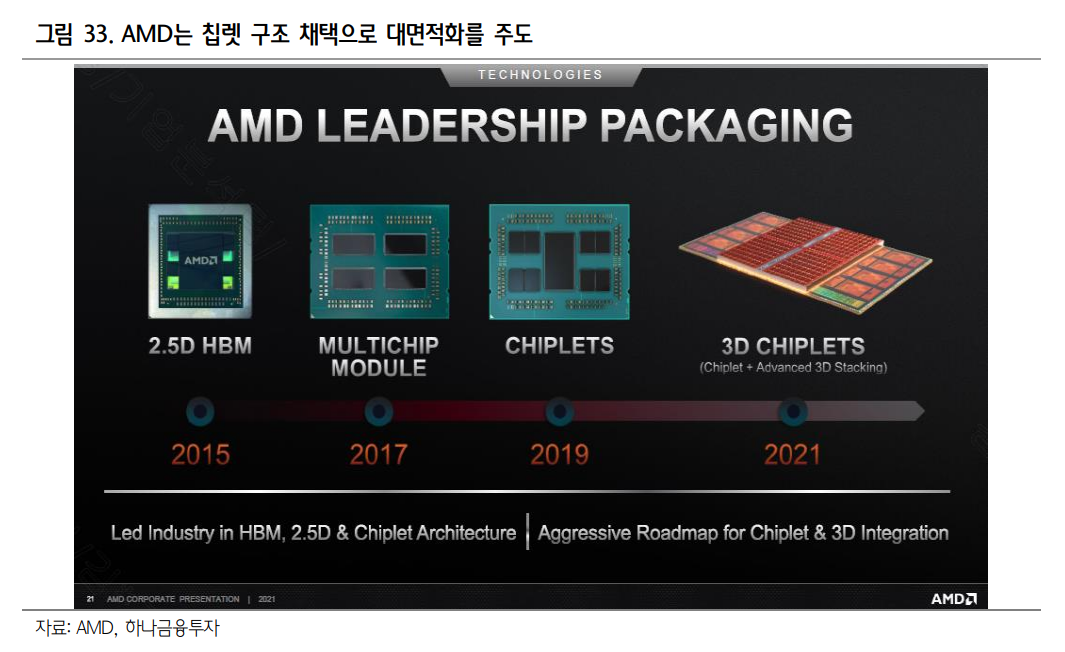
RF향 SiP, AiP 의 전망
FC-BGA와 더불어 성장률이 높을 것으로 예상되는 기판은 모듈 기판이다. 그중에서도 RF향 SiP기판의 성장 기대감이 높다.
통신용 반도체는 기본적으로 CPU대비 성능과 가격이 낮기 때문에 굳이 비싼 FC-BGA를 사용할 필요는 없다.
가성비 측면으로 SiP가 가장 적합하기에, 통신칩 기판은 SiP기판이 주도하고 있다.
애플의 아이폰 시리즈에 채택되고 있는 AiP는 고주파 5G인 mmWave에 대응하기 위한 독자의 패키지기판으로 안테나와 트랜시버를 하나의 기판에 통합한 것이다. AiP 모듈은 스마트폰의 상부, 하부, 측면 총 3개를 탑재하고, 아직 침투율이 낮아 성장룸이 남아있다.
AiP는 16층으로 이루어져 있어 고다층 패키지판에 속하고 AiP 시장은 LG이노텍이 선접하고 있다. 이로 인해 LG이노텍은 FC-BGA 없이도 높은 영익률을 달성했다.
이렇게 5G 스마트폰 침투율 확대와 웨어러블 디바이스의 확장이 SiP와 AiP의 성장을 이끌 것이다.
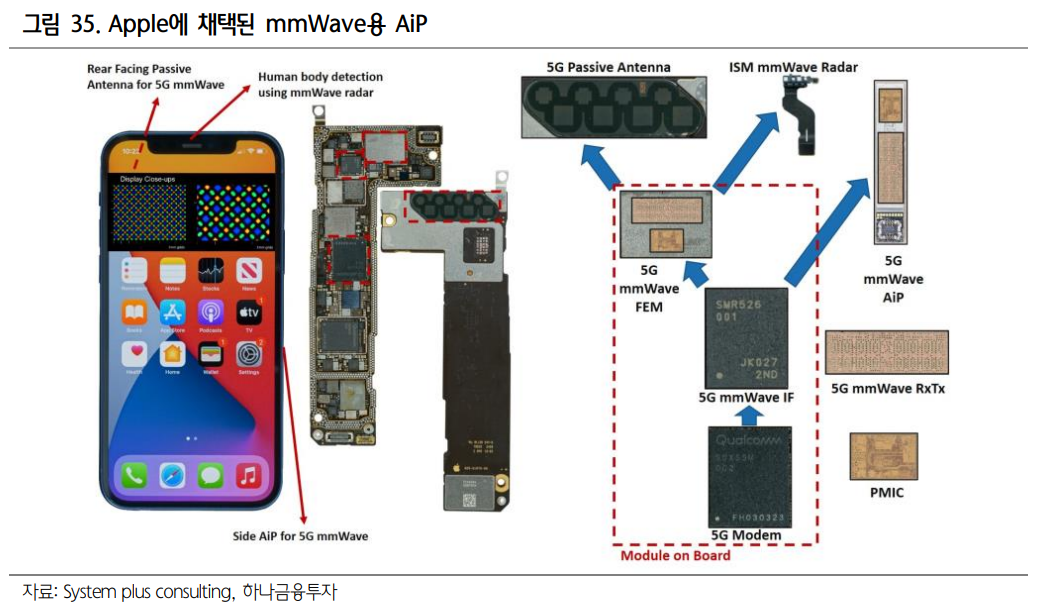
FC-BGA의 수요와 공급 전망
장기적으로 FC-BGA의 수요는 계속 늘어날 것이 분명하기에 기판 업체들도 대규모 CAPEX 투자를 집행하였다. 이러한 투자에도 불구하고 FC-BGA 공급량 증가는 다소 제한적일 것으로 보인다.
그 이유는 수율 확보가 쉽지 않기 때문이다.
FC-BGA는 다른 반도체 기판 대비 양산 난이도가 매우 높으며 따라서 수율 확보가 쉽지 않다. 또한 기판 장비 리드 타임이 2년을 넘는 상황으로 FC-BGA 공급 증가는 23년까지는 급격히 증가하기 어렵고 24년부터 점차 늘어날 것으로 보인다.
최근 23년 1분기 삼성전기 컨퍼런스 콜 내용을 잠시 살펴보자
패키지솔루션 사업부 매출은 YoY 23% 감소했다. 글로벌 경기 둔화에 따른 스마트폰, PC 수요 악영향 때문이다. FC-BGA는 PC용 기판 공급은 감소했지만 대면적 고 다층의 서버용 기판은 본격 사업을 진행 중이다. 2분기에도 FC-BGA의 PC향 수요는 약세가 예상되나, 고사양 패키지 기판 수요 성장은 지속될 것으로 전망한다.
결국 삼성전기 컨퍼런스 콜 내용을 통해 알 수 있는 건 경기침체로 전자기기, PC 수요는 꺾이지만 고사양 FC-BGA 성장은 이제 시작이고 장기적으로 보면 우상향이라는 것을 알 수 있다.
과거 반도체 기판 사이클
<~ 2019년, 오랜 기간의 암흑기>
19년 이전까지 반도체 기판은 성장성이 없어 소외되었다.
가장 큰 이유는 전방 시장의 정체였는데, PC 등 주요 IT기기 출하는 이미 오래전부터 성장이 제한적이었고 스마트폰도 15년 이후 성장이 정체되었다.
스마트폰의 경우 공간의 제약이 심해 기판의 크기가 커질 수 없었고 이는 ASP 상승에 제약을 걸었다.
이렇게 성장세가 오랜 기간 주춤하며 관련 업체들의 수익성은 악화되었고, CAPEX 투자도 소극적일 수밖에 없었다.
과거 오히려 공격적인 투자를 집행했던 업체들은 악화된 업황을 이겨내지 못하고 사업을 철수하거나 시장에서 퇴출되며 업계는 재편되어 왔다.

위 그래프는 19년 이전 주요 글로벌 기판 업체들의 매출액 추이이다. 전혀 성장하지 못했던 과거를 한눈에 확인할 수 있다.

암흑기에 CAPEX 투자는 당연히 소극적일 수밖에 없었고 위 그래프 흐름으로 한눈에 확인할 수 있다.
< 2019년~ 코로나 >
코로나를 기점으로 전방 수요가 급격히 좋아지면서 글로벌 탑티어 업체인 아비덴과 신코가 대규모 투자를 집행하기 시작했다.
반도체 생산 공정 난이도가 급격히 높아지며 전공정만으로 성능개선의 한계를 느꼈던 업계에서는 패키징 기술로 성능 개선을 이루려는 시도가 시작되었다.
서버용 CPU의 경우 스마트폰 AP와 달리 공간 제약을 덜 받는다는 점을 활용해 기판 면적을 넓히고 성능을 최대한 활용할 수 있는 구조로 설계되었다.
이러한 분위기 속에서 그동안 미루어 왔던 기판 업체들의 CAPEX 투자가 급 진전되기 시작한 것이다.

탑티어 업체들이 저부가 기판에는 투자를 줄이고 고부가 기판 쪽 투자를 늘리며 기판 수급 밸런스가 개선되었다.
특히나 FC-BGA 기판 공급 부족이 심해져 FC-BGA 사업에 진출하는 업체들이 늘어나게 되었고(저부가 기판 대신 FC-BGA 쪽으로 제품군을 변경하는 등), 이로 인해 공급 과잉이었던 저부가 기판 업체들의 전체적인 수익성은 개선됐다.
오히려 저부가 기판의 쇼티지 현상이 나타나기도 하는 등 전체적으로 기판업계는 호황국면에 접어들게 된다.
< 2023년~, 앞으로 ?? >
현재는 코로나 이후 무리한 유동성과 러시아-우크라이나 전쟁 등으로 인한 인플레이션, 그에 따른 경기가 불황국면으로 접어들고 있다. IT 수요가 꺾이고 반도체 재고는 쌓여가며 반도체 시장은 완전한 다운 사이클에 접어들었다.
현재 다운사이클에서 미래에 대한 준비를 잘하는 기업만이 살아남을 것이고, 여러 경쟁자가 도태된 후 살아남은 자들에게 돌아가는 수익은 더욱 클 것이다.
앞서 언급한 바와 같이 반도체는 더 이상 전공정만으로 성능 개선을 이루기 힘든 영역까지 도달했다. 따라서 앞으로 후공정 패키징 기술이 반도체 성능 개선을 이끌어 갈 것이다.
이러한 방향성은 기판의 면적이 넓어지고 층수가 높이지게 되고, 이는 곳 기판의 ASP 상승을 이끌 것이다.
후공정 성능 향상을 이끌어내기 위한 칩메이커들의 노력에 FC-BGA 기판의 중요성은 더욱 커질 것이다. 서버용 CPU에도 FC-BGA의 중요도는 강화될 것이다.
서버용 기판의 경우 PC와 달리 공간에 대한 제약이 적어 층수와 면적을 대폭 증대시킬 수 있지만 양산 난이도 또한 대폭 증가한다.
기판 면적이 커지면 한 개의 불량이 수율에서 차지하는 비중이 높아지기 때문에 큰 기판일수록 수율은 점점 더 낮아지게 된다.
그리고 공정에 가해지는 부하도 PC 대비 서버가 6배 이상 높다.
기판이 커질수록 공정에 가해지는 부하와 수율 확보가 어려워지기 때문에 대규모 CAPEX 투자에도 불구하고 FC-BGA의 공급 과잉은 단기간에 일어나기 어려울 것이다.

※ 전장에서 기판
차량용 반도체 기판은 크게 저성능 반도체를 패키징 하는 리드프레임과 자율주행에 관련된 고성능 반도체를 패키징하는 FC-BGA로 나눌 수 있다.
고급 내연기관 차량에 탑재되는 반도체는 30여 개, 전기차는 60개, ADAS 탑재 전기차는 80개, 완전 자율주행 전기차는 100개 이상 탑재될 것.
고성능 반도체를 리드프레임으로 패키징 할 수는 없지만, 아직은 늘어나는 전장쪽 반도체의 많은 부분을 리드프레임으로 패키징할 것으로 보여, 당분간은 리드프레임에 대한 수요도 어느 정도 지속적일 전망이다.
전장용 FC-BGA는 ADAS, 자율주행차의 성장과 그 궤를 함께할 것으로 보인다. 고성능 반도체에는 리드프레임을 사용할 수 없어 FC-BGA가 사용될 것이다.
전장용 FC-BGA는 서버나 PC향 대비 양산 난이도나 수익성이 상대적으로 낮은 시장이다. 하지만 자율주행 기술이 성장할수록 양산 난이도와 수익성은 함께 올라갈 것으로 보인다.
'재테크' 카테고리의 다른 글
| XR 산업 공부 (VR, AR 등) (0) | 2023.05.07 |
|---|---|
| 반도체 기판 공부하기 - (2) 기판의 분류 상세 (0) | 2023.05.05 |
| 반도체 기판 공부하기 - (1) (0) | 2023.05.02 |
| 고성능 메모리 DDR5, HBM 공부하기 (2) | 2023.04.22 |
| K 콘텐츠 조정 받고 있나? 아님 나락인가? (0) | 2023.04.13 |



